中心論題:
- RF功率LDMOSFET性能特征
- RF功率LDMOSFET基本結構和制造工藝特點
- 產品設計難點分析和解決方案
- 器件的關鍵參數
- 工藝難點和解決方案
解決方案:
- 設計了特殊柵結構和工藝制造流程
- P-阱和N+源區通過兩次多晶單邊自對準注入形成
- P+阱溝道的雜質濃度和長度是決定器件性能的關鍵因素
引言
RF 功率 MOSFET的最大應用是無線通訊中的RF功率放大器。直到上世紀90年代中期,RF功率MOSFET還都是使用硅雙極型晶體管或GaAs MOSFET。到90年代后期,的出現改變了這一狀況。和硅雙極型晶體管或GaAs MOSFET相比較,硅基LDMOSFET有失真小、線性度好、成本低的優點,成為目前RF 功率 MOSFET的主流技術。
手機基站中功率放大器的輸出功率范圍從5W到超過250W,RF 功率 MOSFET是手機基站中成本最高的元器件。一個典型的手機基站中RF部分的成本約6.5萬美元,其中功率放大器的成本就達到4萬美元。功率放大器元件的年銷售額約為8億美元。隨著3G的發展,RF功率放大器的需求將進一步提高。
RF 功率 MOSFET在無線電通訊領域也有應用,其頻率已延伸至低微波段且輸出功率可達百W以上。它同時也應用于電視(特別是數字電視)功率放大器、雷達系統和軍事通訊中。
隨著新一代無線通訊技術的快速發展和越來越廣泛的應用,RF 功率 MOSFET有著非常樂觀的市場前景。而目前國內使用的RF功率器件仍然依賴進口,國內RF芯片和器件自有產品不到1%,因此,自主開發RF功率MOSFET具有非常重要的意義。
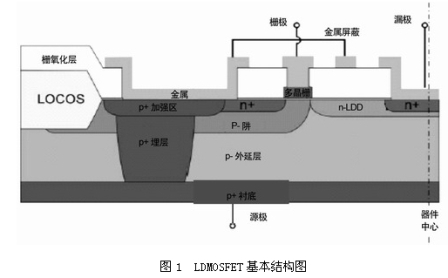
RF功率LDMOSFET性能特征
與硅雙極型晶體管相比,RF功率LDMOSFET有以下優點:
a.工作頻率更高,穩定性好:雙極型晶體管只能在300MHz以下的頻段工作,而LDMOSFET由于反饋電容小,可以在幾百MHz到幾GHz的頻率工作,且頻率穩定性好。
b.高增益:通常在相同的輸出功率水平下,雙極型晶體管的增益為8dB~9dB,而LDMOSFET可以達到14dB。
c.線性度好,失真小:特別在數字信號傳輸應用中,LDMOSFET表現更加突出。
d.熱穩定性好:溫度對LDMOSFET電流有負反饋作用,溫度升高可以限制電流的進一步提高;而雙極型晶體管溫度對電流起正反饋作用,所以LDMOSFET的熱穩定性好。
RF功率LDMOSFET基本結構和制造工藝特點
RF功率LDMOSFET是具有橫向溝道結構的功率MOSFET,它以LDMOSFET為基本結構,利用雙擴散技術在同一窗口相繼進行硼、磷兩次擴散,通過兩種雜質橫向擴散的結深之差精確控制溝道長度。其基本結構如圖1所示,由幾個關鍵結構組成:
a.P+襯底和P-外延層:器件一般會使用P+硅襯底加一定厚度的P-外延層,使用P+襯底是為了源端能很好地從背面引出;P-外延層是為了提高器件的源漏擊穿電壓。
b.P-阱、N+源/漏、柵氧和多晶柵:這是組成MOS結構的基本元素,P-阱和N+源就是通過自對準注入和雙擴散技術形成的。P-阱和N+源注入后在多晶下方橫向擴散,最后形成了MOS的溝道和源區。
c.LDD結構:從多晶柵邊緣到漏端是輕摻雜的LDD(Lightly Doped Drain)區,這個區域可承受源漏之間的高電壓。通過優化LDD區域的電荷和長度,可以使源漏的穿通電壓達到最大值。一般來說,LDD區域的電荷密度約為1011 cm-2~1013cm-2時,可以得到最大的源漏穿通電壓。
d.P+埋層:連接表面源端和P+襯底,工作時電流從表面的源極通過P+埋層流到P+襯底,并從背面引出。這樣不需要另外從正面引線引出,降低反饋電容電感,提高頻率特性。
e.P+ 加強區(P+ enhancement)和金屬屏蔽(shield):P+加強區是為了保證電流從表面的源端通過金屬,流向P+埋層。金屬屏蔽結構是為了降低多晶柵靠LDD區邊緣的電壓,防止熱電子注入效應。
產品設計難點分析和解決方案
通過分析RF 功率 MOSFET器件的性能和結構特征,本文設計了器件的基本結構,并通過工藝和器件模擬獲得了關鍵參數。
器件的關鍵參數
a.柵氧厚度:需根據器件的閾值電壓等設計合適的柵氧厚度。
b.溝道長度、雜質濃度及分布:它們決定器件的開啟電壓,以及源漏之間的穿通電壓,必須經過專門的設計。
c.LDD長度和雜質濃度:LDD區域分擔最大部分的源漏電壓,它的長度和雜質濃度分布必須優化,使得器件的擊穿電壓可以達到最大值,同時LDD區域的電壓分布均勻。
d.外延厚度和雜質濃度:它們決定N+漏和襯底引出的源極之間的縱向穿通電壓。
結合6寸芯片生產線, RF功率MOSFET的制造工藝流程設計完成,包括:P+埋層、LOCOS、柵結構, P阱、源漏和LDD結構,以及接觸孔、鋁、鈍化層。
工藝難點和解決方案
a.柵結構:設計了特殊柵結構和工藝制造流程,以滿足器件功能和頻率特性需要。
b.P-阱和N+源區的自對準注入和雙擴散工藝:器件溝道是通過P-阱和N+源區推進過程中硼、磷的橫向擴散差異形成的。這兩個區域通過兩次多晶單邊自對準注入形成。注入和推進過程需嚴格控制。
c.P+阱溝道:該區域的雜質濃度和長度是決定器件性能的關鍵因素,制造工藝中必須嚴格控制注入和推進過程,保證器件基本性能和均勻性。
結語
本文通過分析RF功率 LDMOSFET的性能和結構特征,設計出RF功率LDMOSFET器件結構,通過工藝和器件模擬確定了關鍵參數,并設計了一套符合6寸芯片生產線的制造工藝流程,對工藝中的難點提出了解決方案。







